반도체 생산 100배 '쑥' 높인 한국산 장비, 일본 제쳤다
전체 맥락을 이해하기 위해서는 본문 보기를 권장합니다.
반도체 후공정의 생산성을 기존보다 100배 이상 높일 수 있는 '갱본더(Gang-Bonder)' 장비를 한국기계연구원(이하 기계연) 송준엽 부원장 연구팀과 반도체 장비업체 ㈜프로텍이 공동 개발했다고 11일 밝혔다.
이 장비는 머리카락 한 가닥(약 40~70㎛)의 절반보다 얇은 20마이크로미터(㎛)급 유연 반도체 칩을 파손 없이 고집적 유연기판에 배열하고 조립정밀도 ±2㎛ 이내로 접속·적층시킬 수 있는 대면적 규모의 패널 레벨 패키지 조립 장비다.
이 글자크기로 변경됩니다.
(예시) 가장 빠른 뉴스가 있고 다양한 정보, 쌍방향 소통이 숨쉬는 다음뉴스를 만나보세요. 다음뉴스는 국내외 주요이슈와 실시간 속보, 문화생활 및 다양한 분야의 뉴스를 입체적으로 전달하고 있습니다.
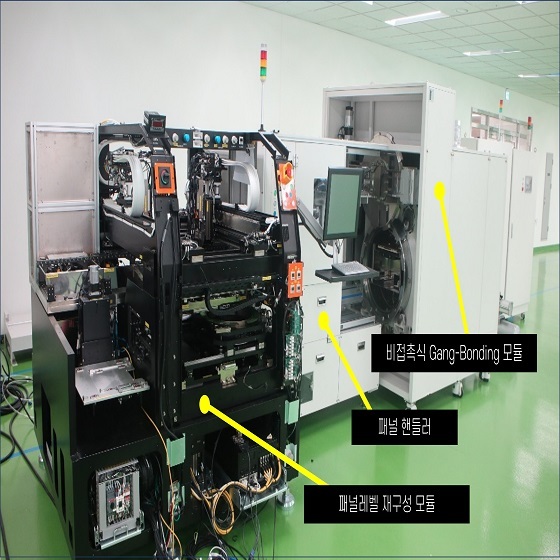
반도체 후공정의 생산성을 기존보다 100배 이상 높일 수 있는 ‘갱본더(Gang-Bonder)’ 장비를 한국기계연구원(이하 기계연) 송준엽 부원장 연구팀과 반도체 장비업체 ㈜프로텍이 공동 개발했다고 11일 밝혔다.
이 장비는 머리카락 한 가닥(약 40~70㎛)의 절반보다 얇은 20마이크로미터(㎛)급 유연 반도체 칩을 파손 없이 고집적 유연기판에 배열하고 조립정밀도 ±2㎛ 이내로 접속·적층시킬 수 있는 대면적 규모의 패널 레벨 패키지 조립 장비다.
패널 레벨 패키지는 반도체를 웨이퍼나 각각의 칩 단위가 아닌 패널 단위로 한 번에 패키징해 생산속도를 크게 향상한 후공정 기술이다.
연구팀은 비접촉식 압력 인가 방식과 다중 셀 세라믹 히터 기술을 핵심으로 하는 갱-본딩(Gang-Bonding) 방식을 적용, 300㎜×300㎜ 이상 대면적 유연 반도체 패키지 패널 조립 장비를 개발하는데 성공했다.
연구팀은 “열에 의한 휨이나 손상을 최소화하고 생산성은 극대화한 것”이라며 “향후 반도체 칩 후공정의 생산성을 획기적으로 개선할 것으로 기대된다”고 말했다.

연구팀은 기존의 일반적인 후공정 방식(TC Bonder)과 갱본더 방식의 생산성을 비교한 결과 시간당 반도체 생산량(UPH)이 100배 이상 증가하는 것을 확인했다.
갱본더 기술은 기존의 반도체 칩을 기판에 하나씩 조립하던 방식과 달리 여러 개의 칩을 동시에 조립하는 기술이다. 낮은 온도에서 일차적으로 칩을 간소하게 조립한 다음 다시 대량의 칩을 일괄 전기 접속하는 방식이다. 반도체 칩에 가하는 열손상은 줄이고 생산성은 높인 차세대 방식으로 세계적으로 아직 상용화된 사례는 없다는 게 연구팀의 설명이다.
연구팀은 갱본더 방식의 패키징을 구현하기 위해 특수기체를 이용해 칩과 접촉하지 않고 압력을 인가하는 기술을 개발했다. 이 방식을 활용하면 칩 또는 기판의 두께 편차가 발생하더라도 균일한 압력을 가할 수 있고 칩의 정렬이 틀어지는 조립 오차를 해결할 수 있다.
현재 반도체 패키징 조립은 개별 칩마다 조립 헤드부분이 기계적으로 압력을 가하는 방식으로 이뤄진다. 이때 칩과 기판의 두께에 편차가 생기면 조립 오차가 발생할 수 있어 한 번에 만들 수 있는 양에 제한이 있었다.
연구팀은 또 300㎜×300㎜ 이상의 대면적을 20℃/sec 이상으로 고속 승온 및 냉각할 수 있는 다중 셀 세라믹 히터(온도 균일도 ±2% 이내)도 개발했다. 유연 기판을 셀로 나눠 가열하되 이를 동시에 진행해 균일한 열전달이 가능하게 한 기술이다. 기존의 방식은 대면적을 한 번에 가열하는 단일 셀 구조로 열충격에 의한 히터 파손 문제로 가열 성능에 한계가 있다. 또 온도 분포가 균일하지 못해 안정적으로 공정을 지속하기 어렵고 생산성을 확보하기도 어렵다. 이 기술을 적용하면 생산 공정 속도는 높이고 불량은 줄일 수 있다.
송 부원장은 “이번에 개발한 장비는 유럽, 일본 등 반도체 장비 선도국가의 소수 업체가 주도하고 있는 최고 사양의 반도체 조립 장비보다 앞선 세계 최고 수준의 기술”이라고 말했다.
이어 “웨어러블 디바이스, 스마트카드, 메디컬 디바이스, 마이크로LED 디스플레이뿐만 아니라, AI 반도체 패키지와 같은 웨이퍼 및 패널 레벨 패키지 초정밀 조립 분야에도 활용될 수 있어 관련 산업의 고속 성장에 따라 새로운 장비산업 창출로 확대될 것으로 기대된다”고 덧붙였다.
<저작권자 ⓒ '돈이 보이는 리얼타임 뉴스' 머니투데이, 무단전재 및 재배포 금지>
Copyright © 머니투데이 & mt.co.kr, 무단 전재 및 재배포 금지
- 윤계상·이하늬, 7년 열애 종지부.."좋은 동료 사이로"
- 10일 지난 고기, 바뀐 레시피..백종원 "이거 아니다"
- 변수미가 보낸 카톡 "X같은 X아"..BJ 한미모 이어 피해자 2명 등장
- 윤계상-이하늬, 열애 7년만에 결별하나..소속사 "확인 중"
- 양준일 '성희롱' 발언 사과 하루도 안 지나..해맑은 웃음 인증샷
- 북한 김정은, 과학자 업어줬는데…정찰위성 2호 발사 '감감무소식' - 머니투데이
- 2월에만 직장인 월급 11% 올라…다른 달과 달랐던 이유 - 머니투데이
- "왜 국민이 낡은 집 살아야 하나"... 재개발·재건축 골든타임은 지금 - 머니투데이
- "부동산 최대한 빨리 팔아라"…PF 위험노출액 '200조' - 머니투데이
- 유재환, 결혼발표 후 터진 '사기·성희롱 의혹'…SNS 싹 다 지웠다 - 머니투데이